文章內容
扇入型與扇出型晶圓級封裝(FIWLP與FOWLP)


❐ 扇入型與扇出型晶圓級封裝的定義
晶圓級封裝技術已經發展超過十年的時間,慢慢演變出許多不同的種類,但是基本的原理不變,這些種類只是由原本的技術改進出來的變形而已。
➤扇入型晶圓級封裝(FIWLP:Fan-in Wafer Level Package)
由於晶圓級封裝的體積很小,在有限的面積上無法製作太多的金屬接腳(鍚球),一般晶片最上層的金屬凸塊(Bump)都是製作在晶片的四周,因此晶片中央的區域沒有金屬凸塊(Bump),如果要增加金屬接腳(鍚球)數目,最簡單的方法就是利用「導線重佈層(RDL:Re-Distribution Layer)」技術,以導線重佈層將電訊號由晶片四周的金屬凸塊(Bump)向內分散到晶片中央的區域,可以增加金屬接腳(鍚球)數目,如<圖一(a)>所示,由於導線重佈層是由外向內散佈,所以稱為「扇入型(Fan-in)」。
➤扇出型晶圓級封裝(FOWLP:Fan-out Wafer Level Package)
如果扇入型(Fan-in)以導線重佈層將電訊號由晶片四周的金屬凸塊(Bump)向內分散到晶片中央的區域仍然不夠怎麼辦呢?那只好以導線重佈層將電訊號由晶片四周的金屬凸塊(Bump)向外分散到晶片以外的區域囉!如<圖一(b)>所示,由於導線重佈層是由內向外散佈,所以稱為「扇出型(Fan-out)」。
這裡要特別注意,晶圓級封裝原本的定義是必須在晶粒切割前先完成相關的封裝與測試製程,但是要做到扇出型,則必須先將晶粒切割以後再製作「導線重佈層(RDL)」,因此算是有點不符合晶圓級封裝的定義,但是它仍然是使用類似半導體製程進行封裝,因此我們仍然將它歸類為晶圓級封裝。
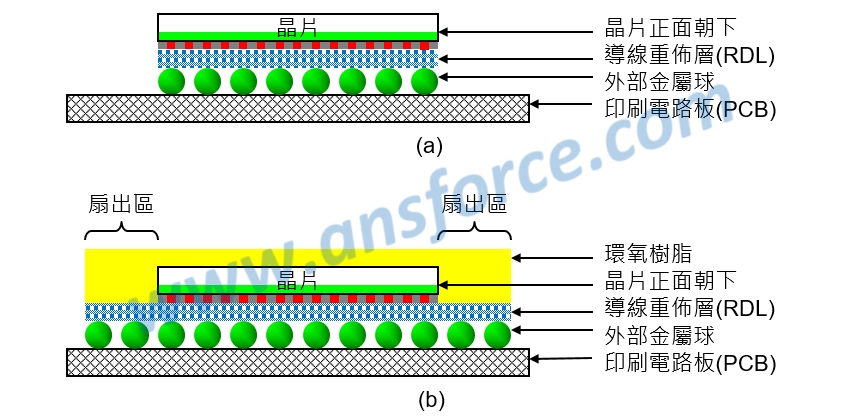
圖一 扇入型與扇出型晶圓級封裝示意圖。
❐ 導線重佈層(RDL:Re-Distribution Layer)
導線重佈層的構造如<圖二>所示,主要是配合覆晶封裝使用,導線重佈層的功能與導線架完全相同,也是將「集中在一起」的電訊號「分散開來」,只是構造不同,導線架是直接將金屬接腳折成像蜘蛛腳的形狀,而導線重佈層是使用印刷電路板的製作方式將金屬線路埋藏在一塊很小的塑膠板內,而這些金屬線路其實也是一端「集中在一起」,另一端「分散開來」。
積體電路(IC)的封裝都是在「封裝廠」中進行,傳統的封裝有點像是傳統的機械工業,使用機械鋼嘴打線與加壓加熱,只是比較精密而已,但是這種新的封裝技術則是利用「晶圓廠」的技術直接在晶圓上進行,因此稱為「晶圓級封裝(WLP:Wafer Level Package) 。
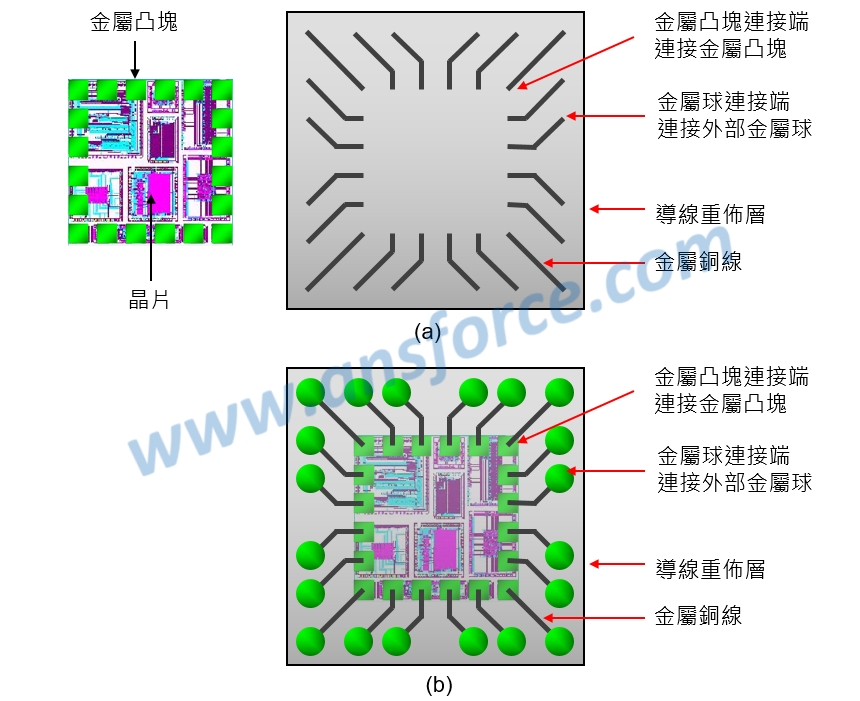
圖二 導線重佈層構造示意圖。
❐ 扇出型晶圓級封裝的製程
扇出型晶圓級封裝(FOWLP)必須使用「載體(Carrier)」固定晶片,最常使用的載體是「玻璃(Glass)」,因為玻璃成本較低又容易切割,詳細製作流程如<圖三>所示:
➤暫時貼合層:使用玻璃基板做為載體,在上方塗布「暫時貼合層(Release layer)」,如<圖三(a)>所示,暫時貼合層是為了方便製程完成後將玻璃基板與導線重佈層(DRL)分離時使用。
➤導線重佈層:將導線重佈層(DRL:Re-Distribution Layer)貼合在暫時貼合層上,如<圖三(b)>所示。
➤覆晶封裝:在晶片的黏著墊(Bond pad)上方製作「金屬凸塊」;再將晶片反轉加熱使金屬凸塊「全部一次」連接導線載板上方的「金屬連接點」,可以同時覆晶封裝許多晶片,如<圖三(c)>所示。
➤模造成形:填充強力膠(環氧樹脂)將晶片整個包覆起來以保護晶片,如<圖三(d)>所示。
➤載體移除:將玻璃基板切割成一顆顆的積體電路(IC),再移除暫時貼合層將玻璃基板與導線重佈層(DRL)分離,玻璃基板只是切割時的支撐物因此必須移除,如<圖三(e)>所示。
➤金屬植球:將外部金屬球「全部一次」連接導線載板上方的「金屬連接點」,就完成整個封裝步驟,如<圖三(f)>所示,這種封裝外部大多使用「球格陣列(BGA:Ball Grid Array)」,因此又稱為「嵌入晶圓級球格陣列(eWLB :Embedded Wafer Level Ball Grid Array)」。
最後系統整合商(SI)再將這個封裝好的積體電路(IC)加熱連接在印刷電路板(PCB)上,如<圖三(g)>所示,由於導線重佈層是由內向外散佈在「扇出區(Fan-out area)」,因此可以量增加金屬接腳數目,而封裝後的體積仍然維持很小的體積,台積電利用這樣簡單的技術成功進入2.5D與3D晶片封裝領域,並且順利在2015年擠下三星獨吞蘋果A10處理器訂單,並且在2016量產,應用於iPhone 7。
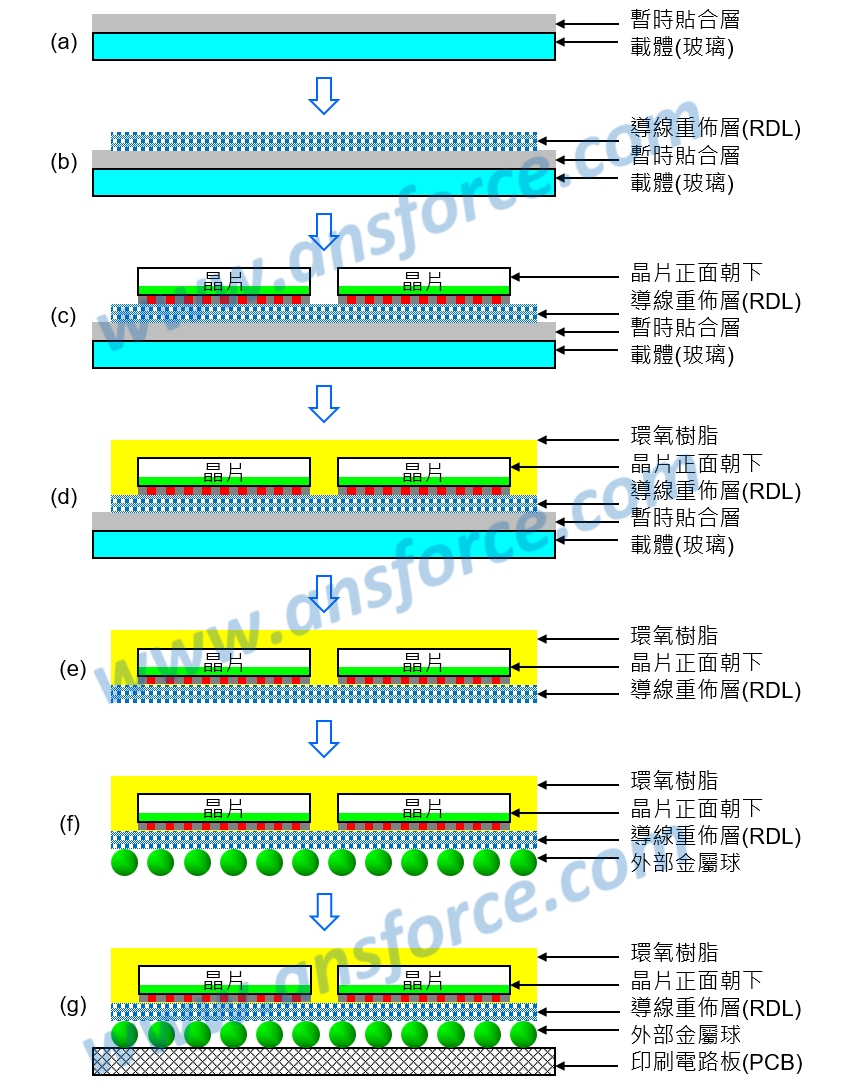
圖三 扇出型晶圓級封裝製程示意圖。
【請注意】上述內容經過適當簡化以適合大眾閱讀,與產業現狀可能會有差異,若您是這個領域的專家想要提供意見,請自行聯絡作者;若有產業與技術問題請參與社群討論。
【延伸閱讀】其他詳細內容請參考「積體電路與微機電產業,全華圖書公司」。<我要買書>
